专区平台
封装,Package,是把集成电路装配为芯片最终产品的过程,简单地说,就是把铸造厂生产出来的集成电路裸片(Die)放在一块起到承载作用的基板上,把管脚引出来,然后固定包装成为一个整体。
蝶形器件封装
封装采用一种标准蝶形封装器件,包括封装壳体,封装壳体外设有管脚,管脚穿过封装壳体引入壳体内,封装壳体内从下至上依次设有半导体制冷片,热沉块和电路基板,
电路基板上设有热敏电阻和主要芯片等,管脚经过壳体部分均经过密封处理,封装壳体内部充斥惰性气体且完全密封,气密性好,且各个部件的导热性良好,整个器件运行环境稳定,可以保证器件参数的长期稳定性。
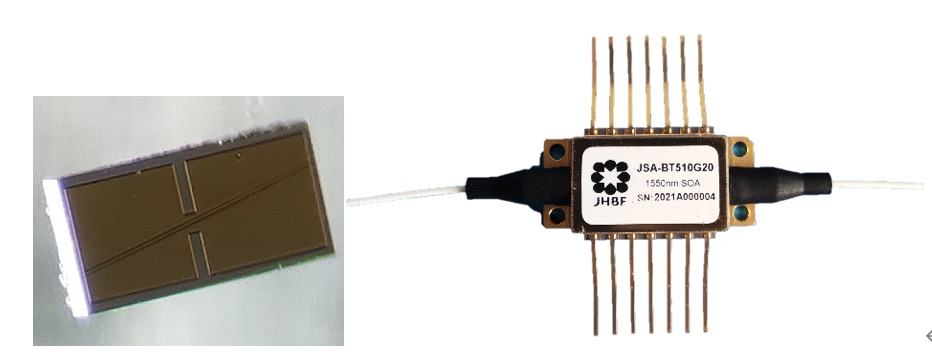
芯片封装
安装半导体集成电路芯片用的外壳,起着安放、固定、密封、保护芯片和增强电热性能的作用,芯片上的接点用金线连接到封装外壳的引脚上,这些引脚又通过印制板上的导线与其他器件建立连接。
特殊光芯片混合集成封装
根据客户需求,定制封装管壳,将不同功能的光芯片进行光路整合,实现光路优化及损耗最低,并保证实现新的特殊功能的混合集成封装方式,并保证其可靠性,气密性,稳定性等各项性能指标。
激光雷达光芯片混合集成封装及测试
根据客户需求,定制封装管壳,将不同功能的激光雷达芯片进行光路整合,实现光路优化及损耗最低,并保证实现新的特殊功能的混合集成封装方式,并保证其可靠性,气密性,稳定性等各项性能指标,
并可以对其功能进行完整的测试并出具测试报告。

封装的发展进程
结构方面:TO->DIP->PLCC->QFP->BGA->CSP;
材料方面:金属、陶瓷->陶瓷、塑料->塑料;
引脚形状:长引线直插->短引线或无引线贴装->球状凸点;
装配方式:通孔插装->表面组装->直接安装
光芯片贴片
桌面半自动贴片机,精度±5μm3sigma,贴装器件尺寸范围 0.03~20mm,键合力控制 20-500g
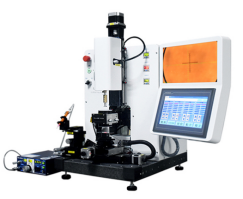
光芯片共晶焊
1可焊焊料熔点 :≤450℃
2控温精度:≤±1℃
3加热板面积:(350×290) mm2
4有效面积内热均匀性:≤±2%
5极限真空度:≤5Pa
6工作真空度:10-15Pa
7最大升温速度:≥2℃/S
8最大降温速度:≥1.5℃/S
9可放器件最大高度:100mm
10可编程数量:≥150组
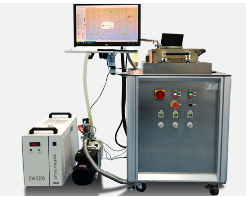
光芯片低速打线
适用范围:分立器件、微波组件、激光器、光通讯器件、传感器、MEMS、声表器件、RF模块、功率器件等
焊线种类:金丝(15um-75um)、铂金丝(20um-25um)、银丝(18um-50um)
超声波:0~5W,1000倍细分
压力:1-250g,1g分辨率
适配劈刀长度:16mm、19mm
器件腔深:12mm以内
器件长度:200mm以下
热台温度:室温~200℃
设备净重:45kg
操作比率:1:8

光芯片高速打线
适用范围:分立器件、微波组件、激光器、光通讯器件、传感器、MEMS、声表器件、RF模块、功率器件等
焊线种类:金丝(15um-75um)、铝丝(18um-75um)、金带(50umX12.5um-100umX25.4um)
超声波:0~5W,1000细分
压力:1-250g,1g分辨率
适配劈刀长度:19mm、25mm
器件腔深:17.5mm以内
器件长度:200mm以下
热台温度:室温~200℃
设备净重:45kg
操作比率:1:8
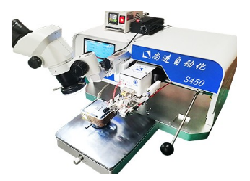
光芯片耦合-六轴透镜耦合系统

平行缝焊
本机适用于边长5~150㎜扁平式金属壳座的封装及光电器件的蝶形封装;
滚焊速度:>2㎜/s;
焊接电源:逆变式脉冲焊接电源;
不合格率:<3‰;
工作室露点:≤-40℃;
供电电源:单相、220V、3KVA(含烘烤箱);
氮气压:>0.2MPa(液氮);
压缩气压:>0.4MPa;

蝶形器件封装
封装采用一种标准蝶形封装器件,包括封装壳体,封装壳体外设有管脚,管脚穿过封装壳体引入壳体内,封装壳体内从下至上依次设有半导体制冷片,热沉块和电路基板,
电路基板上设有热敏电阻和主要芯片等,管脚经过壳体部分均经过密封处理,封装壳体内部充斥惰性气体且完全密封,气密性好,且各个部件的导热性良好,整个器件运行环境稳定,可以保证器件参数的长期稳定性。
芯片封装
安装半导体集成电路芯片用的外壳,起着安放、固定、密封、保护芯片和增强电热性能的作用,芯片上的接点用金线连接到封装外壳的引脚上,这些引脚又通过印制板上的导线与其他器件建立连接。
特殊光芯片混合集成封装
根据客户需求,定制封装管壳,将不同功能的光芯片进行光路整合,实现光路优化及损耗最低,并保证实现新的特殊功能的混合集成封装方式,并保证其可靠性,气密性,稳定性等各项性能指标。
激光雷达光芯片混合集成封装及测试
根据客户需求,定制封装管壳,将不同功能的激光雷达芯片进行光路整合,实现光路优化及损耗最低,并保证实现新的特殊功能的混合集成封装方式,并保证其可靠性,气密性,稳定性等各项性能指标,
并可以对其功能进行完整的测试并出具测试报告。